|
|
 |
 |
Atom Source |
 |
| カタログダウンロード |
日本語 |
English |
| カタログダウンロードはこちらをクリックして下さい |
 |
 |
|
| |
Atom SourceはECR(Electron Cyclotoron Resonance)方式によるプラズマソース本来の高純度、高密度プラズマ中からのニュートラルビーム(アトムフラックス)を発生します。 フィラメントレス構造の為O2、H2 等のリアクティブガスの導入が可能です。プラズマ生成部は高純度の絶縁材料で構成され、その他の構成材料も全てUHVプロセスでの使用に耐える構造です。CF114(DN63CF)フランジマウントによるコンパクトな本体は外部からの導波管接続を必要としません。ユーザーによる面倒なチューニング作業も不要です。アプリケーションに応じてAtom/Ion(Hybrid)Sourceの対応も可能です。
(詳細は弊社までお問合せください。) |
 |
| |
|
| |
Applications |
● Nitriding e.g. GaN, AlN, GaAsN SiN etc.
● Hydrogen cleaning, hydrogen assisted MBE.
● Oxidation e.g. ZnO, Superconductors, Optical coatings.
● Compatible with MBE, PLD, Sputter deposition systems.
● Nitrogen Doping |
| |
| Key Fuatures&Basic Comprises |
| |
● フィラメントレス
酸素、水素、窒素等のリアクティブガスの解離が可能です。
●CF114フランジマウント
コンパクト、マイクロ波導波管の接続を必要としない省スペース構造
●チューニング不要(Factory Set)
ユーザーによる面倒なチューニング作業は不要です。
●Full UHV対応
UHV環境下で使用可能な材質で構成されています。
●ベークアウト>200℃ |
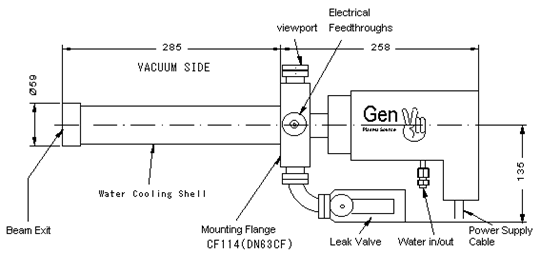 |
| |
| Specifications |
|
|
 |
|
フラックス強度
Atom Flux
|
>2x1016 atoms/cm2/s at 10cm |
|
半値角
Beam Divergence
|
~ 15° half-angle typical |
|
イオン化ガス
|
N2, O2, H2 (any most other non-condensible gases) |
|
動作圧力
Working Pressure
|
1x10-8 mabr to 1x10-1 mbar typical (using 500l/s pump) and depending on selected grids, pump, optional differential pumping and gases. |
|
Working distance:
|
<50mm to >300mm (150mm typical) |
|
オプション:
|
(1) Residual Ion Trap (removes ions from beam)
(2) Differential pumping (for operation at very low or high vacuum levels)
(3) Ion source retrofit kit
(4) Plasma igniter
(5) Plasma Detection (sensor to detect if plasma is on)
(6) remote control option A (externally swich on/off microwave power)
(7) remote control option B (to extermnally control microwave power, ion traps via 0-10V analog signal) |
|
| 参考文献 (Reference) |
- ● The role of neutral oxygen radicals in the oxidation of Ag films. A. A. Schmidt, J. Offermann and R. Anton. Thin Solid Films 281-282 (1996) 105-107.
- ● Design and performance of a versatile cost-effective microwave ECR plasma source for surface and thin film processing. R.Anton, T. Wiegner, W. Naumann, M. Liebmann, C. Klein, C. Bradley. Rev.Sci.Instr. Feb 2000
 |
| |
| ご注意:カタログに記載の内容は予告なく変更される場合があります。(Vol:2008-04) |
| |
 |
|