|
|
 |
 |
水素解離源(H-Flux) |
 |
| カタログダウンロード |
日本語 |
English |
| カタログダウンロードはこちらをクリックして下さい |
 |
 |
|
| |
| 水素クラッカーセル |
|
|
 |
|
H--flux
Atomic Hydrogen Source
H--flux は水素(H2)ガスを原料として解離水素を生成するサーマルクラッキングセルです。解離効率に優れ、イオン化成分を残さない高効率の水素専用クラッカーセルです。
タングステンキャピラリーを電子衝撃加熱する独自の加熱方式により、安定した高いフラックスレートを実現し、同時に基板への放射熱影響や荷電粒子の到達を許さない優れた基本性能を充足します。(下図右側参照)
水冷シールドされた構造は超高真空環境下で、他のコンポーネントへの熱影響や真空チャンバーからのガス放出を誘発することなく運転を可能にします。 |
| |
|
- このソースユニットはフラックス中に基板ダメージとなるエネルギーの高い荷電粒子成分の混入がなく、解離熱の放射影響を抑える優れたデザインコンセプトで製作されています。
水素ガス導入部から熱解離部まで連続するキャピラリー構造は高い解離効率を実現し、同時にフラックスの指向性を高める機能を担います。また、磁場を使わない電子収束方式の為、磁場影響を嫌う他の装置ユニットとの併設も可能です。ヒートシールド(水冷)構造と一体となったユニットデザインは完全UHV対応のコンパクトな構造です。マウントポートは既設装置への取り付けも容易なCF70(NW35CF)フランジです。
|
|
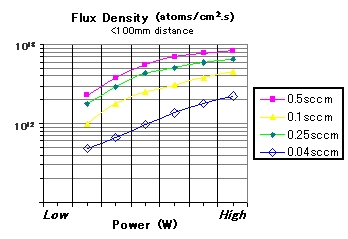 |
| |
|
|
エピタキシャル成長(MBE、GS MBE)を始め、各種デバイス作成分野、表面ダイナミクス、表面科学研究分野にも応用されています。
●GaAs, InP, Ge,Si等 基板の低温ダメージフリークリーニング.
GaAs、InP基板への高品位エピタキシャル成長における重要な前処理工程では、解離水素フラックスのアシスト照射により、基板加熱温度は200℃以下の低温でCarbonコンタミネーションの除去を可能にします。Oxygenコンタミネーションでは約400℃近傍の加熱で同様の効果が期待できます。
damage free in situ cleaning e.g GaAs, InP, Ge and Si. Removal of residual oxygen and carbon.
●Si 基板の表面調質/GaAs on Si substrate
Si基板のIn-SituクリーニングからGaAs成長過程のアシストビーム
●MBEによるGaAs 2D Growthプロセス時のアシストビーム
●界面状態処理−レイヤー界面、または成膜中のレイヤー構造の改善
Surfactant – improvement of layer properties during growth
●基板表面の調質
post growth surface treatment/improvement
●化学的不動体表面の形成や表面改質
chemical passivation and surface reconstruction |
|
| |
| Specifications |
|
|
 |
|
|
|
 |
| 注)minimum leak rate=1x10E-8Torr-litter/sec |
| |
| Options |
|
|
|

|
|
【ソースユニットオプション】
● TC “Type C “ リードアウト端子
(W5%Re26%Re)
● フラックスシャッター(手動、自動)
● フラックスアパーチャ
●水素キャニスター(小型水素ボンベ)
【制御オプション】
● 温度制御/PIDループ制御
● マスフロー制御
|
| |
 |
|
 |
|
| |
|
|
|